
如何减轻BGA载板翘曲和PCB翘曲
在电子封装产品中,因为各种材料的热膨胀系数(CTE)不同,加上各材料的模量差异,在封装生产过程中又经过不同的温度变化,产品很容易出现翘曲变形的问题。对于一些高端封装产品来说,翘曲的程度对产品的质量及可靠性尤其重要,特别是一些超薄堆叠芯片和微间距BGA封装的产品,如果在前期产品设计时未充分考虑到翘曲问题,在后面的实际产品中就会有很大的风险出现产品内部芯片裂损、材料分层、产品外部平面度异常等一系列问题,最终可能造成产品无法成功生产。
BGA封装或PCB经历任何加热周期和随后的冷却周期时,都有可能发生翘曲。这可能会使封装中间拱起,导致桥接或开路。通过X射线检查桥接或通过内镜检查或目视检查开路时,可发现桥接会导致向上或向下推封装角。如果PCB翘曲,则可能导致各种其他元器件出现开路或短路。
问题的原因
BGA和PCB翘曲是各种元器件封装材料(例如IC封装载板,硅芯片和EMC)之间的热膨胀系数(CTE)不匹配而导致的。温度升高的速率会影响放置和移除元器件过程中的温度均匀性,因此该速率与翘曲严重程度间接相关(图1)。
图1:由于BGA翘曲而导致开路。
而且,IC封装载板尺寸越大,在所有其他条件相同的情况下,出现这种翘曲现象的机率就越大。当然,返工加热方式(热风返修系统,红外线,热风回流炉,汽相炉等)也会产生影响。采用低CTE散热材料,调节CTE,部分或完全消除此问题是可能的。
一些塑料球形栅阵列(PBGA)包括散热器,这使得BGA封装的顶部会以比BGA底部更快的速率散热;会导致向下挤压BGA角。BGA中的水分也可能导致器件想要在中间扩散的翘曲。在这些情况下,拐角可能会向上卷曲。
通过一系列实验设计,您可能需要确认BGA或PCB的哪一部分在翘曲。隔离在推或在拉的表面对于如何解决问题是非常有用的。
如何减轻翘曲问题
对于BGA翘曲,会看到器件角的位移最大,这可能导致许多开路和桥接发生。同样,电路板也可能向上或向下翘曲并推入焊膏中,从而导致桥接或开路。目检或X线检查都可发现这类缺陷。
减少翘曲的方法之一是减慢加热和冷却过程。在预热期间加速并在冷却期间减速。当然,现在,在冷却时,你不想太慢,因为你不想产生粗粒度结构。与电子制造业中的许多事情一样,都需要做出权衡。
控制MSD器件(包括板和元器件)是另一种有助于减轻翘曲影响的方法。J-STD-0033和JEDEC湿气处理指南将是适当处理MSD的最佳标准。如果翘曲与吸湿有关,预烘烤板和元器件,然后将它们保持在干燥的环境中将可减轻问题。限制电路板和元器件的暴露时间和了解电路板和元器件的MSD级别也将大会大减轻与吸湿相关的翘曲。
通过采用减少枕头效应的焊膏配方,允许焊膏适当融合,焊料球翘曲的影响也将是有限的(图2)。
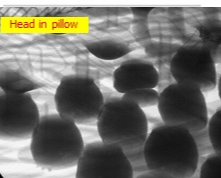
图2:枕头效应缺陷
通过适当地工程设计沉积在每个焊盘位置的焊膏量,可以限制与PCB翘和器件翘曲相关的一些问题。在某些情况下,增加一些焊盘的焊膏印刷量,而在其他情况下,减少其他焊盘的焊膏印刷量 - 可能有助于补偿翘曲影响。例如,在BGA朝向PCB向内弯曲的情况下,可能会有短路的迹象。在这些区域,可能需要最小化印刷量。相反,在BGA弯曲离开电路板的区域,较大的印刷量可能是最佳解决方案。
如果电路板翘曲(IPC-TM-650 2.4.22测量弓曲和扭曲测试方法),那么您可能需要使用其他方法来减少器件或电路板翘曲的影响(图3)。除了前面提到的方法,您可能需要重新设计电路板,以确保电路板的铜分布更均匀。板的低散热(即,较低铜含量)区域将以不同于高散热区域的速率散热。此外,可能需要使用较厚的板布置非常薄的板(0.020英寸)。最后,可能需要在构建电路板或器件时采用CTE比较匹配的不同材料。
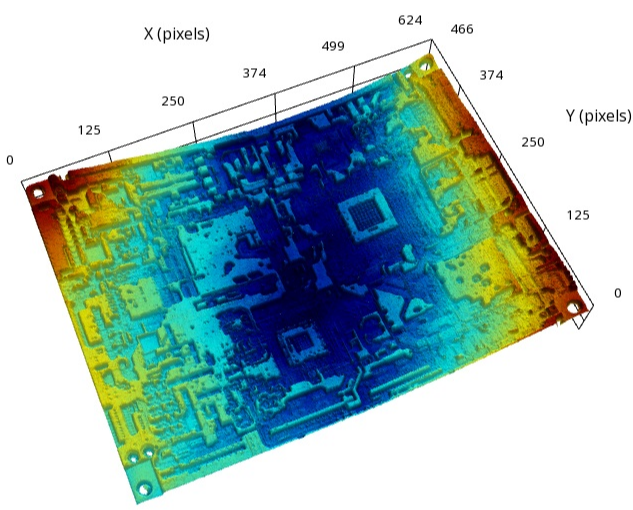
图3:Shadow moiré测量示意图。